非线性器件
Info
这是《电路与模拟电子技术》课程的第二部分:模电。我经过对教材和老师PPT内容的整理和取舍编写了该笔记,供大家学习或复习。在上模电部分的时候我的感受是讲的内容太多,重点不够突出。因此我选择了我认为从做题角度最清晰明了的脉络来呈现这部分笔记,因此和书本以及老师上课的顺序会有不同。
非线性电路¶
概念¶
非线性电路是至少含有一个非线性元件的电路
非线性元件没有固定的参数
非线性元件用这样的方式表示

模电里的V表示电压
非线性元件有几种分类方式
对称与不对称:特征曲线关于原点对称的就叫对称元件
可控与不可控:
不可控元件:只有两个端钮,可用一条特征曲线表示。如钨丝、二极管等。
可控元件:有三个或三个以上的端钮,要用一族特性曲线表示。如三极管、可控硅等。
压控型和流控型
如果电流是电压的单值函数,就叫压控型
如果电压是电流的单值函数,就叫流控型

对于U为y轴I为x轴的图,动态参数是某点的切线斜率,静态参数是某点到原点的斜率。



直流非线性电阻电路¶
有图解法和解析法
图解法¶

这里串联电流相等,所以把U相加就是整体的U。然后呢相应的US找到对应的I,就是总的电流,然后和原来两个特性曲线的交点就是各个电阻上的U
新曲线是等效串联电阻的伏安特性曲线
串是电流相等的时候电压相加

并是电压相等的时候电流相加

首先看u1和u2关于i1, i2的图,这是两个稳压二极管,它们串联是电流相同的情况下电压相加,所以得到了左下角这个图里的蓝色部分。左下角这个图里的绿色部分是u0和R上电流的关系。R和两个稳压二极管是并联的关系,电压相同(u0)的时候电流是和的关系,u0不可能超越±uz,这叫钳制,最终表现出来的特性曲线是红色的部分,这时R和两个稳压二极管并联的伏安特性曲线。而要画出的伏安特性曲线,还要把这个和Rs串联,于是画出Rs的伏安特性曲线也就是右下角的图的绿色线,再和红色线进行串联,也就是电流相同的时候,电压相加,就得到了棕色线,也就是总的伏安特性曲线。所以分析这种题目都用串并联对图象影响的角度来分析
解析法¶
KCL, KVL, 支路电流法,回路电流法,网孔电流法,节点电压法,替代定理,特勒根定理是可以用的(其中回路电流网孔电流节点电压需要改造),其他的线性叠加戴维宁互易是用不了的
但是如果你只是对于线性的部分进行分析,还是可以用戴维宁等效的

节点电压法做这个题需要改造,因为比如你想要用的时候有自电导,但是非线性元件没有固定的自电导。
为了弄得可以做就把非线性元件用电流源替代(替代定理能用)
小信号分析法¶
小信号:独立电源在它原有的固定值上叠加一个振幅很小的信号,其值是如此之小以致并不影响非线性元件的运行情况
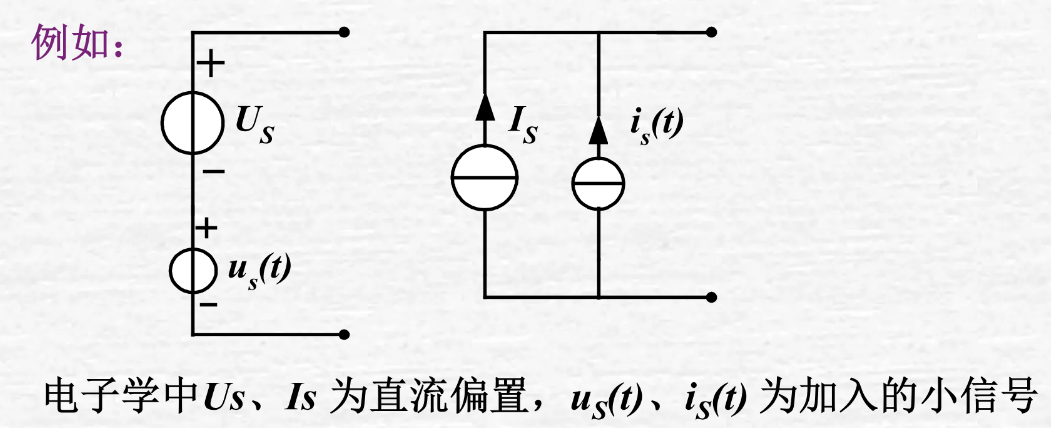
小写的是小信号,这里说的直流偏置意思是给非线性元件达到一个直流稳态的状态,在伏安特性曲线达到一个点,所以偏置就是让它设定一个基准

u1(t)和i1(t)是加了小信号之后达到新稳态时电压电流的变化量

小信号分析的步骤就是首先求出原来的直流工作点,然后求出这个点处非线性元件的动态电阻,然后令直流偏置置零,小信号单独作用,求小信号电压电流u1(t), i1(t), 最终u=U0+u1(t), i=I0+i1(t)。这实际上是用了叠加定理,因为它把小信号作用时的非线性元件当成线性元件了(只保留一次项)。
这是模电里面的处理思想:有条件线性。本质就是,把非线性元件伏安特性曲线上某点附近的关系用那点处的切线替代了。然后这个替代并不是全局的,只是那一小段里面的。

二极管压降是用i=1mA带入而二极管的伏安特性曲线得到的,这个动态电阻你反解u对i求导求出来也是一样的

有人会纠结小信号电路里怎么二极管发生了反向的电流,但是注意小信号里面,任何元件仅仅看它的伏安特性曲线,实际的电流是直流偏置和小信号的和,对于左上电路,电流是i=(1-0.05sinwt)mA,这里很明显小信号相比直流分量来说很小(小于十分之一),整体仍然是正的。这种情况叫做“驮载”

半导体元件¶
概念¶
本征半导体指完全不含杂质且无晶格缺陷的纯净半导体,材料比如有硅、锗及砷化镓,温度越高,载流子浓度越高
热激发运动(电子成为自由电子)和复合运动(自由电子吸引回去)达到动态平衡,电子空穴对维持一定浓度,且电子和空穴的浓度相等
电子空穴对浓度越高半导体导电能力越高
给半导体掺入有用的杂质,比如P磷,就成了杂质半导体。由于P掺进Si之后会多一个电子,所以自由电子就多多了。掺P的叫做N(negative)型半导体(因为电子多,空穴少),电子浓度相对空穴浓度是百万比1的数量级。
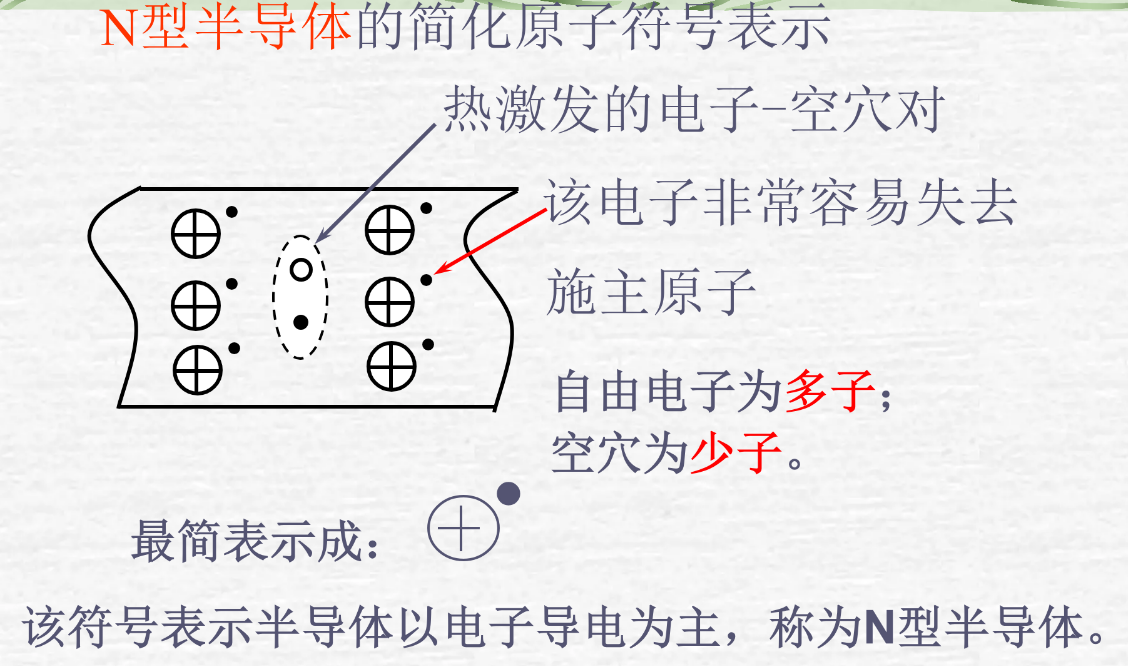
如果掺B硼,少一个电子,有一个空穴,所以空穴就很多,叫做P(positive)型半导体(空穴多,电子少)

载流子在外加电场中的定向运动称为漂移运动,扩散运动是由浓度差导致的

D是表示扩散运动快慢的物理量
\(V_T\)=26mV要记忆
PN结¶
PN结是P型半导体和N型半导体之间的一层微米级的空间电荷层。

那部分的空穴和电子因为扩散运动给搞没了,因此PN结也叫做耗尽层。
PN结形成的内建电场阻碍多子顺浓度的扩散运动,所以PN结到了一定宽度就不再扩张。这里对于P端,多子(空穴)受电场力阻碍其漂移过去N,而少子(电子)受电场力作用就会容易过去。对于N端就是反过来。

稳定时,对于某一侧来说,扩散过去多少个(这一侧)多子,内建电场就会再把多少个(这一侧)少子漂移过来。
某一侧掺杂浓度越高,形成的这一侧的PN结的厚度越小,因为只需要很小的体积就可以把另一端的给消耗掉了
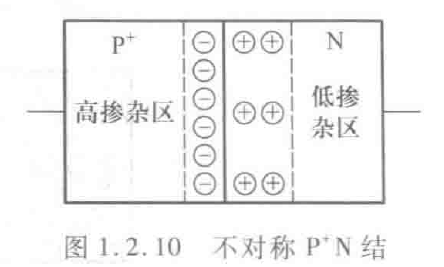
偏置PN结就是给PN结两侧加电压
正偏PN结是P接正极,N接负极,此时外加电场是从P指向N,与多子扩散方向相同,与内建电场方向相反,两个电场叠加起来,原本阻碍多子扩散的电场被削弱。那么原本的“耗尽层”就会重新有多子填充进来,所以导致耗尽层厚度减小乃至消失,于是PN结导通,也就是二极管导通了。
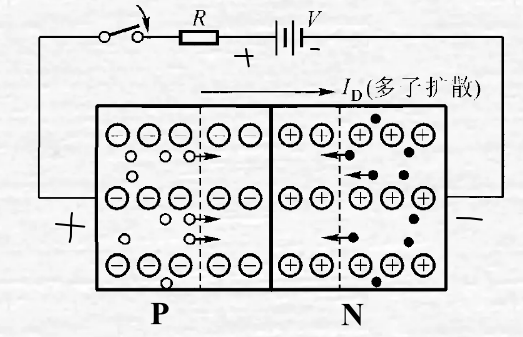
此时正向电流是多子的扩散电流。
反偏的话,P接负极N接正极,外加电场和内建电场方向相同,这样是阻碍多子扩散的,增加了PN结厚度,不再导通。这样反过来是促进少子的漂移的,所以只会有微弱的电流。此时PN结/耗尽层是扩大的
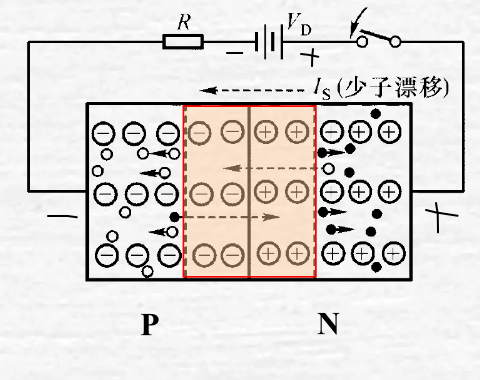
此时反向电流是少子的漂移,非常少,加压达到一定程度之后电流不再增加,因为少子浓度不够了,此时电流为反向饱和电流。少子浓度由温度来决定的,温度越高这个饱和电流也越大。
一个PN结就是二极管,满足伏安特性
正偏的时候,那个1可以忽略了,差不多就是一个指数。反偏的时候,指数项可以忽略了,差不多就是-I_S,这个在nA级别

然后反向击穿,可能是因为反向电压太大了,把共价键里的电子也弄出来了(齐纳击穿),所以载流子增加了;也有可能是因为少子漂移的时候速度太快去撞了价电子(雪崩击穿),也是把载流子增加了。
反向击穿(齐纳、雪崩击穿)称为电击穿,这是可逆的
若反向电流*反向电压>容许耗散功率称为热击穿,这是不可逆的,这种就是烧毁了
PN结还有电容特性
正偏时以扩散电容为主(Diffusion),反偏时以垫垒电容为主(Barrier)
C=dQ/dv
C_D是扩散电容,C_B是垫垒电容,这两个都在pF数量级。
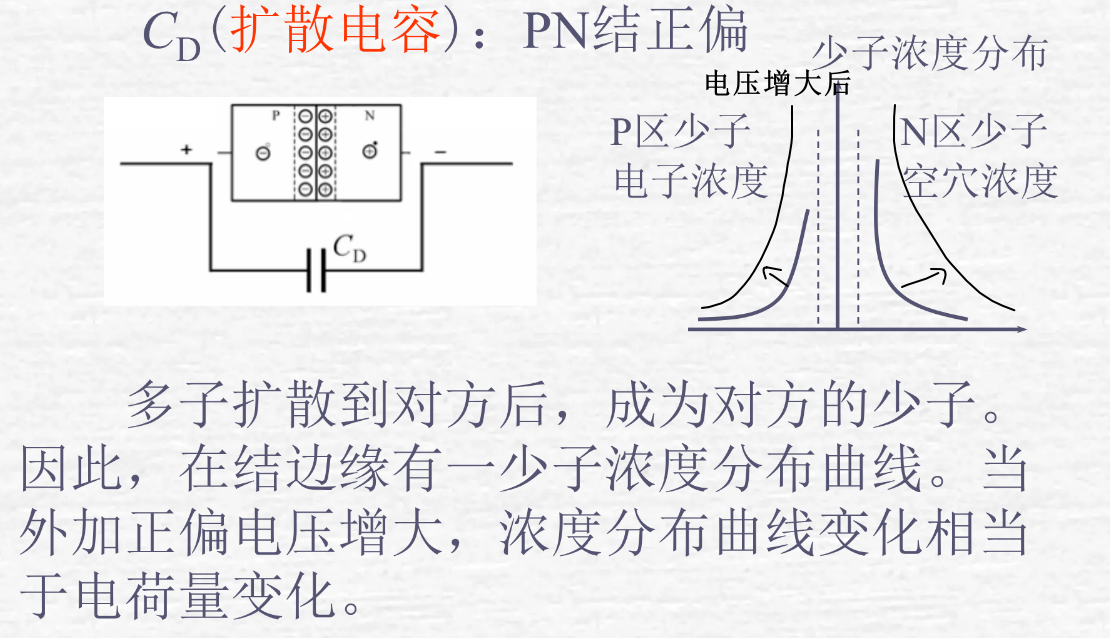
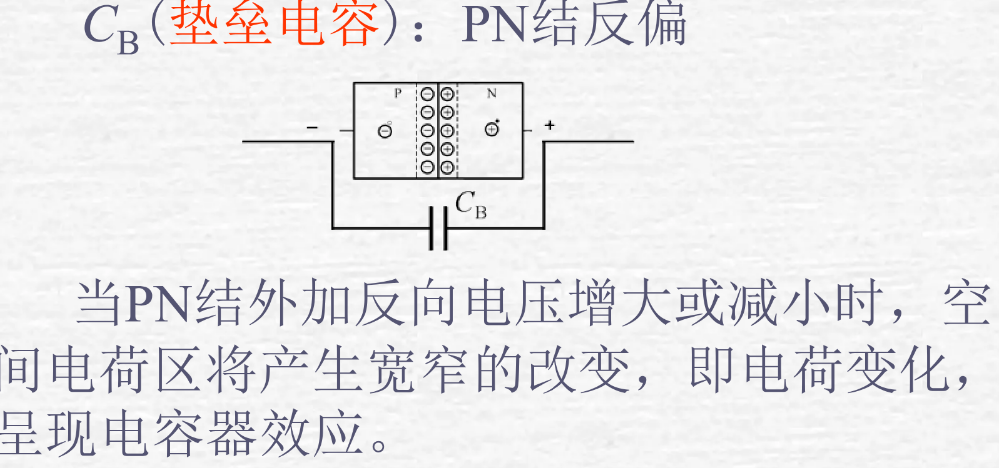
记住二极管的箭头方向是从P到N的

硅管I_S会比锗管更小
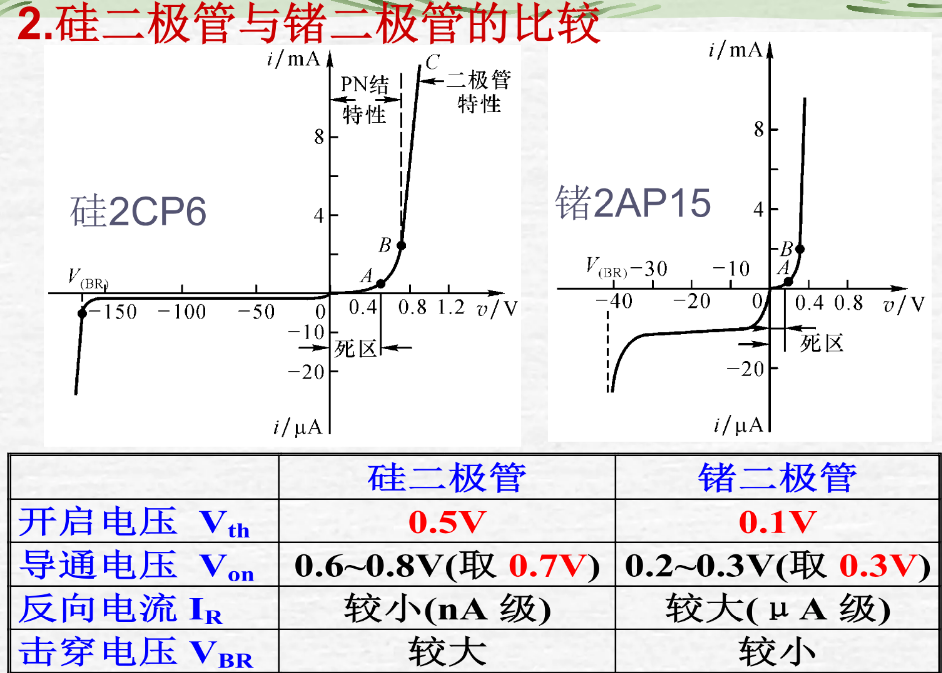
开启电压是离开死区时的电压,导通电压是可以近似成为竖线时的位置
最大整流电流I_F是二极管长期运行时允许通过的最大半波整流电流平均值。整流电流超过此值时,二极管将被烧坏。
反向击穿电压V(BR),当反向电压超过V(BR)时,反向电流剧增,二极管的单向导电性能被破坏,甚至引起二极管损坏。不过对于稳压二极管来说它就是要工作在击穿区,普通二极管反向击穿可能会搞坏。
反向电流I_R,反向电流越小,管子的单向导电性越好。
含二极管电路计算¶
图解法和之前一样
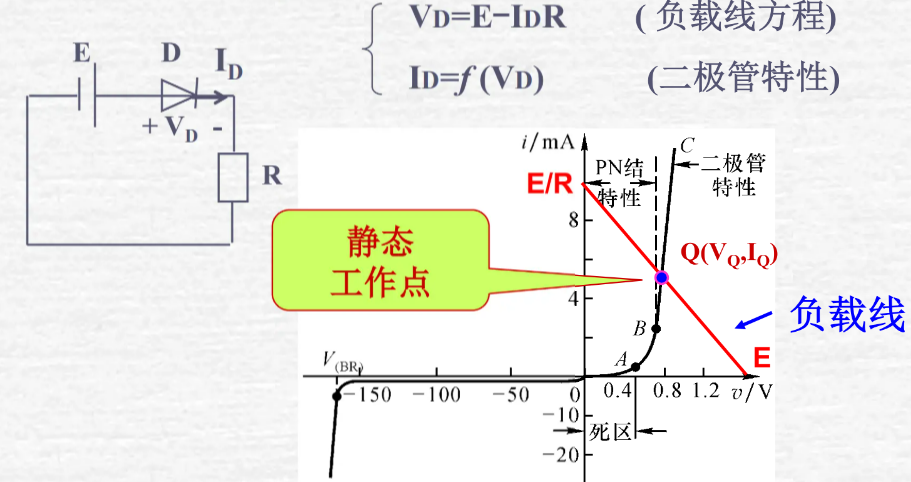
实际电压源对应的那个线叫做负载线方程
二极管模型¶
对于二极管进行建模,大信号模型有理想二极管模型,恒压降模型,折线模型。理想二极管模型就是认为正向短路导通负向截止,忽略了0.7V硅管压降。恒压降模型就是认为正向电压大于0.7V才导通,导通压降0.7V.折线模型就是对于认为正向导通那段类似电阻的特性,有固定的斜率,折线几乎不用,前面两个用的多。

计算的时候,先假设二极管断开,求出两端的电压,如果正向电压大于0.7V就认为导通,把这个二极管用0.7V电压源替代,然后用直流电路的计算它的电流之类的参数即可。
如果有多个二极管,类似地分析,先断开分别求电压。然后遵循一个原则,这样求出来的正向电压更大的优先导通,然后令它为0.7V,然后再去分析剩下的二极管的状态。
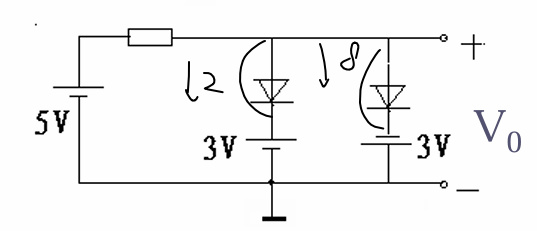
比如这个图,都断开的情况下一个2一个8,此时认为8那个导通,换成0.7V之后就会发现左边那个是不导通的,而不是原来分析出来是2就是导通的

如果是这样多个二极管,就不能简单判断了。右边三个二极管看成一个整体,要超过2.1V才能导通。当Us=3的时候,断开分析似乎都是可以导通的。如果左边导通了,D2D3D4电压成了3.7V,右边可以导通。如果右边导通了,那么D1上的电压为-0.9V,不导通,所以最终结果是D1不导通,D234导通。
当Us=0,断开分析也是可以导通的。如果D1导通,右边不导通,如果D234导通,D1导通。不管哪种情况,D1都导通,所以D1导通,D234截止。
串联的作为一个整体,总之如果用两种情况分析出来的结果,一种是导通一种是截止或者两种都是截止,那就是截止。如果两种都是导通,才是导通。


如果是AB,静态工作点在死区附近,线性偏差大,效果不好,最好是在on的区域来有条件线性,也就是Q2是更好的。
当位于on区域时,用解析法快捷且准确


0.7太小了可以忽略。
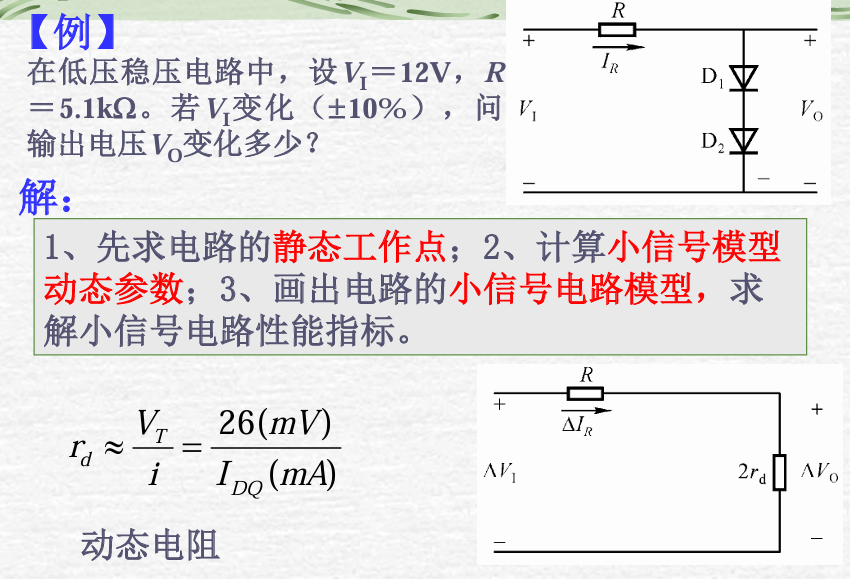

整流电路¶
整流就是用二极管把原来方向会变化的变成只有一个方向的
半波整流

这个二极管需要能够承受最大反压为1.414V2,不能进入反向击穿区。

对于每一个二极管来说其实都只是半波。
其他电路¶

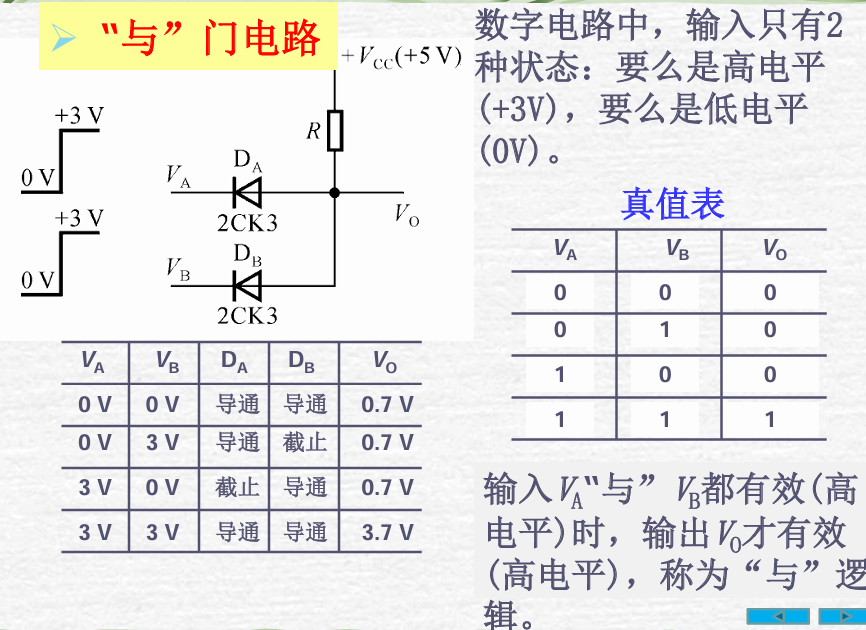
低电平的那个优先导通
稳压二极管¶
稳压二极管通常是用它的反向击穿区,因为它在这个区的电压变化很小可以认为是稳压的。

这两种都是稳压二极管的符号,左边的是新要求,右边的是旧要求的

我再补一个这种是两个反方向的稳压二极管放在一起,这个东西是保证端口的电压只能取±Vz
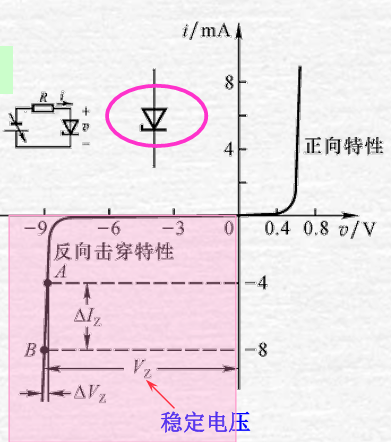
把它接在电路里的时候就是要把它反过来
击穿电压用\(V_Z\)表示
它因为电流电压都挺大的,所以不能让它的功率超过最大允许耗散功率\(P_{ZM}\)。
稳压二极管有最大稳定电流和最小稳定电流,最大是由最大允许耗散功率来限制的,最小是由反向击穿区的开启的位置限制的。
r=ΔVZ/ΔIZ,r越小击穿曲线越陡,稳压特性越好。
稳压二极管用于“轻”的负载,轻的意思是电流小,也就是负载阻值大,这样才好稳定

断开时反向电压超过V_Z说明到达反向击穿。当断开时反向电压恰为V_Z时说明失去稳压作用。


没告诉你最小的稳压电流,那你就认为到达反向电压的时候就是恰好的那个点。


电压源是不变的,置零。小信号来自负载改变导致的电流变化,可以用替代定理来换成电流源。给了动态电阻rz=20Ω。开路的时候IL上没有电流,现在突然RL是1.5k,那么就一下有了IL,这个IL就用稳压二极管的电压除以1.5k得到。rz和R并联的时候就认为是20Ω了,因为越并越小。

其实就是让通过稳压二极管的电流限制在稳压区最小最大电流就好了,搞出一个范围,如果没告诉你最小稳定电流那你就认为是0,这里给了最小稳定电流Izmin,而最大稳定电流是要用最大允许功耗PM/UZ得到的60mA
凡是做这种题,都是用KCL和KVL把稳压二极管的电流表示出来,分别研究下界和上界,然后在最极端的条件下(也就是不等式最难成立)的情况下求得的就是R的边界值。

比如这道题写出来的是\(5mA\le I_Z=\frac {U_1-U_Z}{R}-I_L\le 50mA\),我就不给图了直接给Iz的表达式
研究5mA情况,最难达成,也就是I_Z尽量小,于是得要使得U1取最小值15V,IL取最大值,这样I_Z就是最小的情况,如果在这种情况下都能保证大于5mA那就可以。对于50mA,那就是让I_Z尽量大都无法超过50mA,此时就要让U1取最大,然后让IL取最小。
其他二极管¶
发光二极管:正向电压一般为1.3-2.4V,电压越大越亮,颜色和材料有关

光电二极管:当光超过截止频率,光强越大反向饱和电流越大

变容二极管:反向的时候相当于一个压控非线性电容
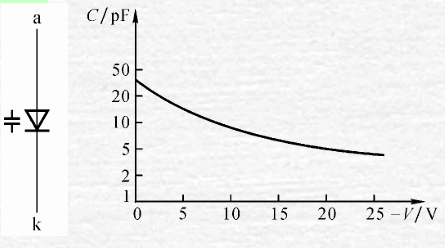
肖特基二极管:有单向导电性,正向导通电压比硅管低,大概是0.4V。开关速度快,开关损耗小,适合用来高频应用

肖特基二极管的符号是有勾回来的,很明显和稳压二极管的不一样
双极型晶体管(BJT)¶
英文BJT-Bipolar Junction Transistor
双极型意思就是有两种载流子
结构¶
有PNP,NPN两种,常见的是NPN
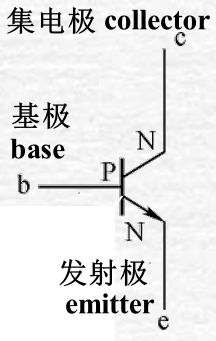
箭头从P指向N,对应发射结正偏时的情况。

PNP是这样的
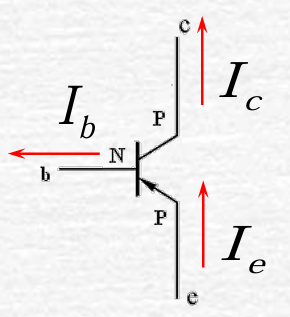
微观原理¶
第一步,从微观原理解释各个状态及其发生条件

发射区e掺杂多,多子电子多,电流主要由这里的电子的迁移导致。基区b薄,掺杂少,减少与e区来的电子的复合,IB由e区电子与b区空穴的复合产生。
VBE>0,VBC>0,两个二极管均正偏,这种状态称为饱和区。此时IE主要由发射区多子电子向上迁移导致,IB主要由发射区多子电子与基区空穴复合导致,IC主要由跨越发射结,没和基区空穴复合,进一步越过集电结到达集电区c的电子造成。之所以可以保证在VBC大于0的时候电子仍然可以前往集电结,因为我们只讨论VCE>0的情况,发射区电子一定是往上跑的。当VCE取较小的正值,VBE>VCE时,就会出现这种情况。注意此时虽然集电结正偏,但是IC并不是来源于P区多子空穴的运动,而是集电极往上的电子的运动。此时VCE较小,抽取来到基区的电子的能力不足,导致部分电子堆积在基区,因此称为“饱和区”,即使来到基区的电子增加,IC也无法进一步增大。
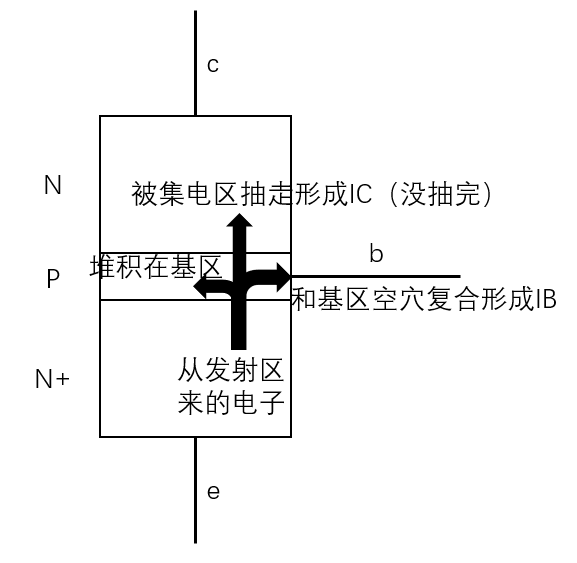
VBE>0,VBC<0,发射结正偏,集电结反偏,这种状态称为放大区。此时IE,IB,IC的形成原因和饱和区一致,但是此时VCE足够大,可以充分抽取从发射区来到基区的电子,使其进一步跨越集电结,不会有未被利用的电子堆积在基区。这个阶段,IC/IB>1且固定,因此IC可以被视为IB的放大,因此称为“放大区”。IB越大,就说明有越多发射区的多子电子被搬运到基区(注意并不是IB搬运的,IB只是被抽到基区的电子和基区的空穴按一定比例复合形成的),此时由于VCE足够大,所有被搬运到基区的电子都被抽走,因此IC不再增长,这是由来到基区的电子总量限制的,由于IB和这个总量有一个比例关系,所以也可以认为IB限制了IC。
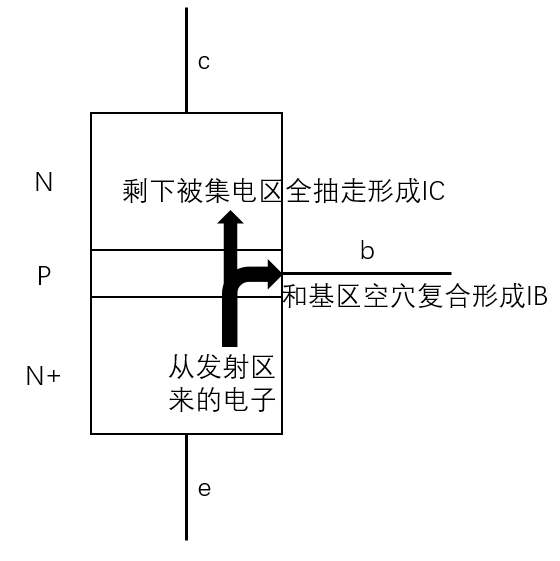
VBE<0时,由于我们只讨论VCE>0的情况,所以此时VBC一定小于0,也就是当满足VBE<0, VBC<0时,发射结反偏,集电结反偏,这种状态称为截止区。此时发射区的电子不再能被抽到基区,于是此时电流非常小,可以忽略。因为电流几乎为0,相当于截止,所以称为“截止区”。
共射组态输入输出特性曲线¶
第二步,解释曲线各个部分所在的区
在接三极管的时候有三种接法,分别记为三种组态,如下图

左边的网孔是输入端,右边的网孔是输出端,三极管的哪个极既在左边网孔里又在右边网孔里,那就叫共什么极组态。最常见的是共射组态,专门研究共射组态时的输入输出曲线。

这是共射极输入特性曲线。当VCE=0,VBE>0时,发射结正偏,集电结正偏,在饱和区。VBE越大,从发射区被抽到基区的电子就越多,于是这些电子与基区多子空穴的复合数量增加,于是IB增加。
当VCE>0但很小时(在该图上没有表现出来,比如VCE=0.2V的曲线),VBE>0时。当VBE小于VCE时(这是很小的一段),发射结正偏,集电结反偏,不过由于电压太小,电流不明显,就认为接近0。VBE大于VCE时,发射结正偏,集电结正偏,在饱和区,分析结果和前面VCE=0时一样
当VCE较大,比如VCE=1V时,由于VBE最多也就0.7V(PN结最大导通压降),所以集电结一定是反偏的,发射结是正偏,在放大区。IB随VBE增大的原因与前面一样。当VCE增大,集电区从基区抽取电子的能力增大,基区电子和空穴的复合作用比较弱,抢不过集电区,所以电流随VCE增大而减小,不过幅度不明显,因此通常来说VCE>1V的曲线就认为是同一条了。
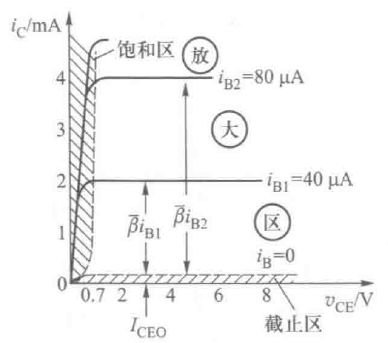
这是共射极输出特性曲线。当IB=0,发射结一定是零偏或者反偏,否则一定会有部分发射区电子跑到基区和空穴复合,IB就会有正向电流。此时由于发射结反偏,集电结反偏,位于截止区,此时电流非常小,可以忽略。
当IB固定(被抽到基区的电子量固定),此时发射结一定正偏,只有饱和区或放大区两种情况。当VCE较小时,VCE抽取来到基区的原发射区电子的能力不足,只能抽一部分,随着VCE变大,能抽上来的越来越多,因此IC随VCE增加而增加。此时VCE<0.7,而VBE=0.7,VBC>0,发射结正偏,集电结正偏,在饱和区。当VCE增大到可以把来到基区的所有电子(除了被基区空穴复合的那些电子)都吸走之后,无论再怎么增大VCE,由于这个电子量有上限(IB一定程度可以反映这个上限),所以IC都不会继续增大了。此时VCE>0.7,VBE=0.7,VBC<0,发射结反偏,集电结反偏,在放大区。
当IB增大,说明电子和空穴复合的量增加,也就说明来到基区的总电量增加,所以能被集电区抽走的电子也就增加,所以恒定电流也就增大了。
电路模型¶
第三步,介绍电路中三极管状态的判断和相应模型
假设BE断开,结合外部电路求出来VBE<0,那么就说明三极管位于截止区,认为IB=IC=0

假设BE断开,结合外部电路求出来VBE>0,那么就说明三极管要么在放大区,要么在饱和区。
此时VBE压降为0.7V(硅管),结合外电路可以求出IB。首先假设三极管处于放大区,用IC=βIB求出IC,结合外电路求出VCE。如果VCE>0.7,则假设成立,三极管的确处于放大区。
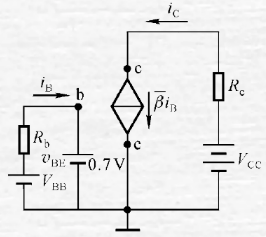
如果VCE<0.7,则假设不成立,三极管处于饱和区,需要重新求IC和VCE。这种情况认为三极管处于“深度饱和”,由于VCE就在0到0.7V之间,对于硅管认为VCE=0.3V,对于锗管认为VCE=0.1V。此时你就拿着这个确定的VCE,结合外电路求出IC即可
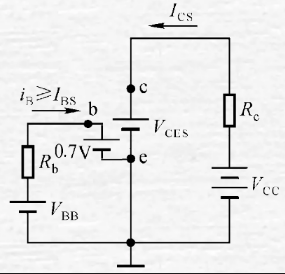
在假设三极管处于放大区的情况下求出VCE=0.7V(硅管)或者0.3V(锗管),这种叫做临界饱和,此时认为求出来的IC也是正确的,因为你就算拿着临界饱和的VCE再去求一遍IC得到的结果也是一样的。
在工程上,判断出来处于饱和区,如果你认为这VBE=0.7V和VCE=0.几可以忽略,那么你直接当作bce三个连在一起短接也是可以的
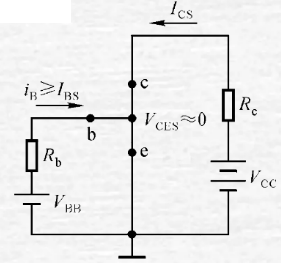
推广¶
介绍了NPN之后,就可以推广到PNP
PNP的特性和NPN就全部反过来,电流的方向要反,电压的方向也要反。为了仍然画成和NPN那样也是在第一象限的样子,iB换了参考方向,所以轴上就不用加负号,而vbe还是vbe,所以就要加负号。而ic也是换了参考方向,然后vce要改成-vce
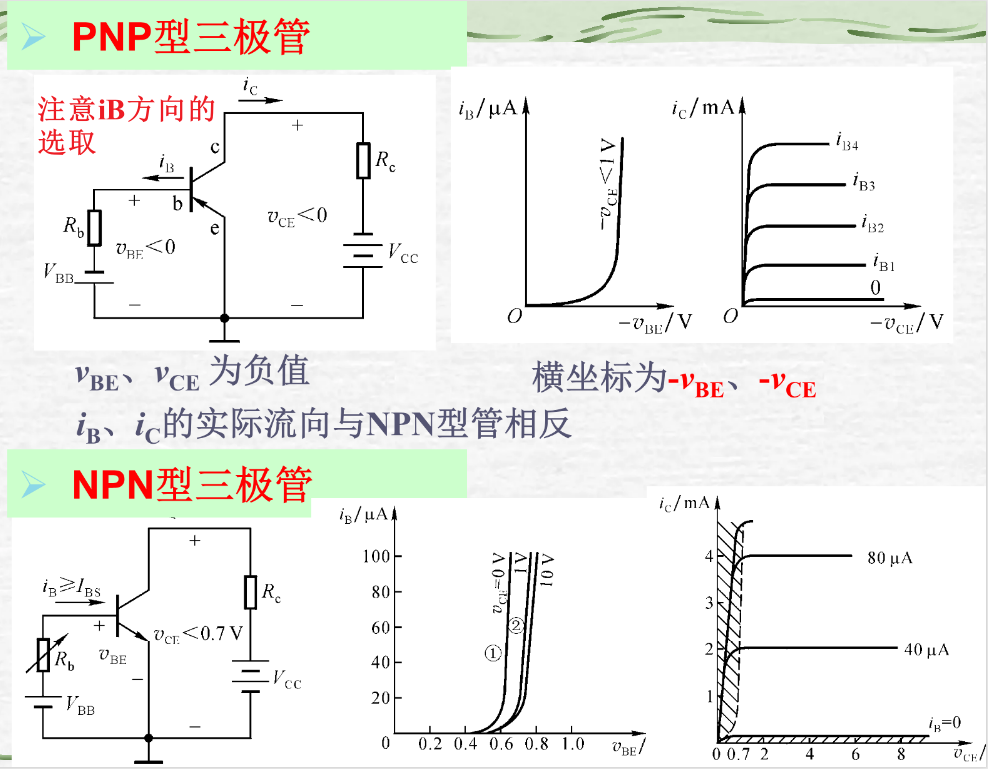
NPN的电流是两个进一个出的,PNP的电路是一个进两个出的。
注意PNP的图里面,IB和IC的参考方向和NPN的是相反的。
参数¶

前面介绍的时候,忽略了发射结正偏和集电结反偏的微小电流,如果要完整表达的话就是这张图里的这样。
集电结反向饱和电流\(I_{CBO}\)是e开路时,集电极与基极加反向电压时,c流向b的电流,在nA级别
穿透电流\(I_{CEO}\)是基极开路时,集电极和发射极之间加电压时,c流向e的电流,因为其实内部就是两个反向二极管,所以肯定有一个反偏,这个电流很小,这个值是越小越好的。
以上两个很小的电流都和温度很相关
如果考虑温度影响(温度会显著影响\(I_{CBO}\)),完整表达式应该为
在建模的时候,忽略很小的\(I_{CBO}\)和\(I_{EP}\),认为\(I_B=I_{BN}, I_C=I_{CN}, I_E=I_{EN}=I_{CN}+I_{BN}\)
设\(I_C=\bar \alpha I_E, I_C=\bar\beta I_B\),由\(I_E=I_B+I_C\)可得\(\frac 1 {\bar\alpha}=\frac 1 {\bar\beta}+1\)(用\(I_C\)表示其他的然后约分即可)
\(I_E=I_B+I_C=I_B+\bar\beta I_B=(1+\bar\beta)I_B\)
\(\bar\alpha和\bar\beta\)经过实验测出来,\(\bar \alpha=0.98\sim0.998, \bar\beta=49\sim 499\)
注意以上的比例关系仅在发射结正偏,集电结反偏的时候成立。
集电极最大允许电流\(I_{CM}\),当\(i_C\)超过\(I_{CM}\)时,电流放大系数β将显著下降。
还有集电极最大允许功耗\(P_{CM}\)
不能过流,过压(电击穿),过功率(热击穿)
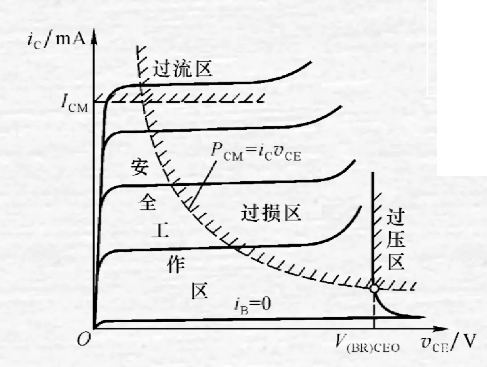
关于温度,输入特性:温度上升时,发射结电压下降;输出特性:温度上升时,输出特性曲线上移,间距增大

例题¶
BJT管的型号标记:
第一个字母是A、B则为锗,是C、D则为硅
第二个字母:G是高频管、K是开关管、X是低频管、D是大功率管
判断是硅还是锗,可以按照放大区或饱和区的VBE来判断,也可以用编号来判断
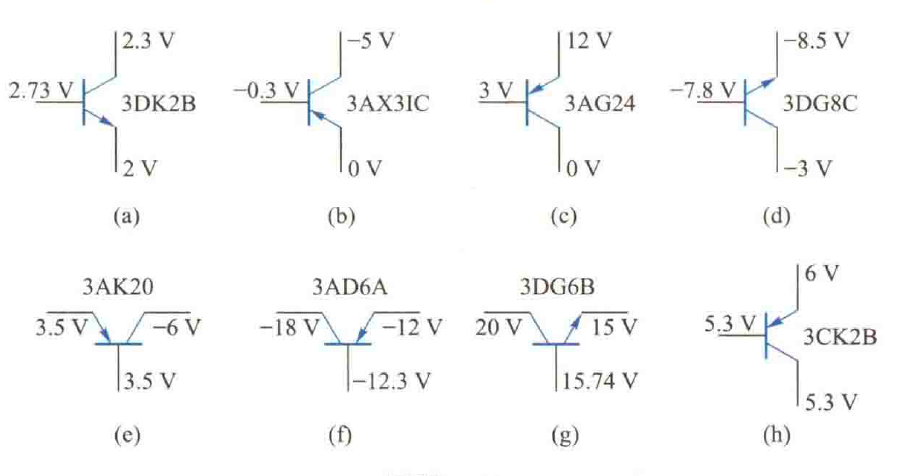

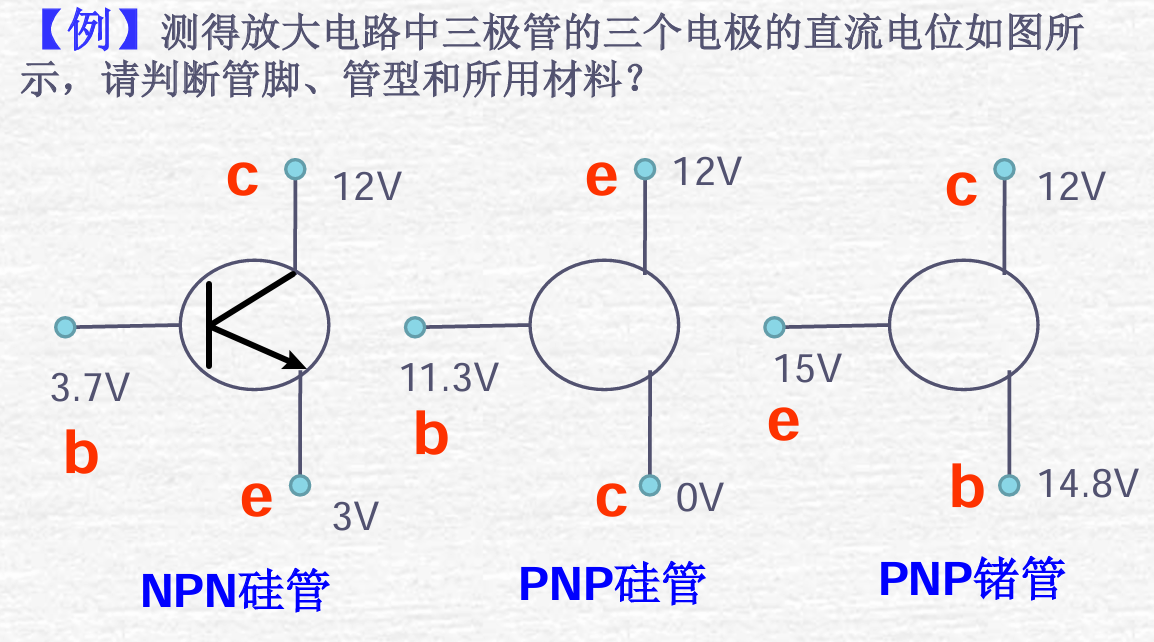
放大电路,无论是NPN还是PNP,都是发射结正偏,集电结反偏。对于NPN,Vc>Vb>Ve,且Vbe=0.7V或0.3V(或0.2V)。对于PNP,Ve>Vb>Vc,Veb=0.7V或0.3V(或0.2V)。获得三个电压之后,先根据压降判断是硅管还是锗管。第一个图3.7和3之间是0.7所以是硅,第二个12和11.3之间是0.7所以是硅,第三个15和14.8之间是0.2V所以是锗管。然后判断是NPN还是PNP,如果正偏(压降0.7或0.3或0.2)发生在较低的两个电势之间,那么就是NPN型,发生在较高的两个电压之间,就是PNP型。
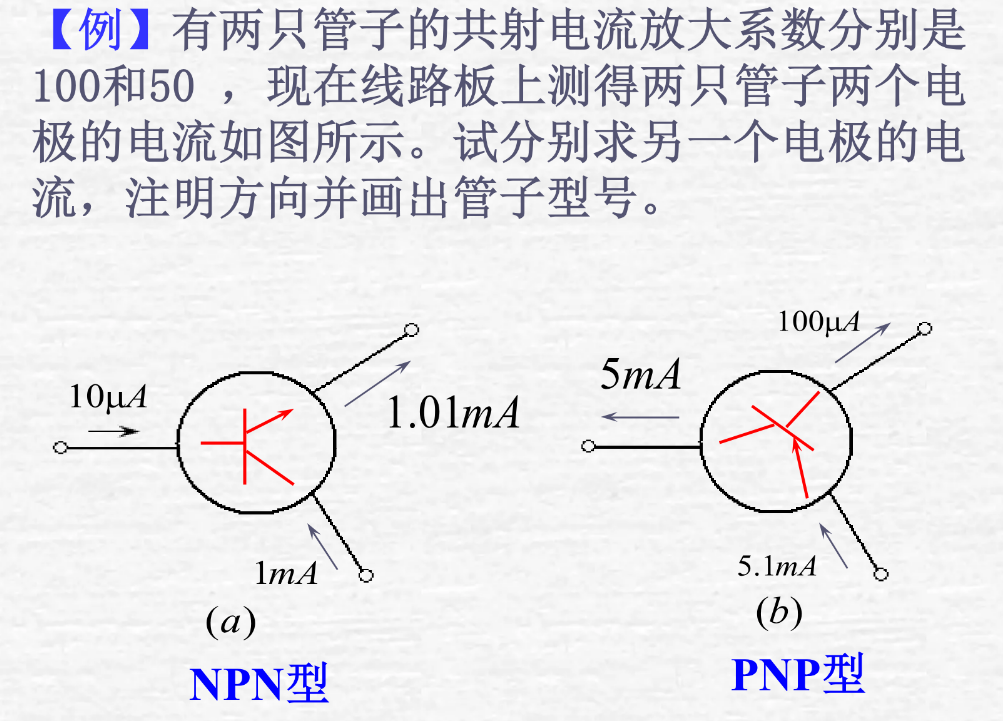
两个进一个出的是NPN,一个进两个出的是PNP。iB是最小的那个。

分析三极管首先判断工作状态。这里做第二题,VBB=15V,先判断发射结(发射结最重要),求出开路电压Vbe是10V,正偏,所以Vbe压降0.7V。这样以来可以从VBB列到VEE的KVL解出IB
现在已知发射结正偏,那就不可能截止了,要么放大要么饱和
假设在放大区,要求Vce,它相当于一个受控电流源,它的电压需要用KVL求出大于0.7V,如果它是饱和区,Vce一定在0到0.7V之间,但是这里算出来是大于0.7,所以一定在放大区

30V的时候求出来Vce为小于0.7V的数,那就说明一定在深度饱和区,不是在临界饱和(否则是0.7V的)
那就用回饱和区的模型,Vce压降为恒定值,然后也是用KVL求电流
-15V的时候发射结截止,那就只能是截止区。
场效应晶体管(FET)¶
又称单极型晶体管
FET管,Field Effect Transistor
分类¶
FET管分为两类,一类是绝缘栅型(MOS),一类是结型(JFET),绝缘栅型可以分为增强型和耗尽型
耗尽型:场效应管没有加偏置电压时,导电沟道就已经存在
增强型:场效应管只有加偏置电压时,才有导电沟道
结型可以归类为耗尽型
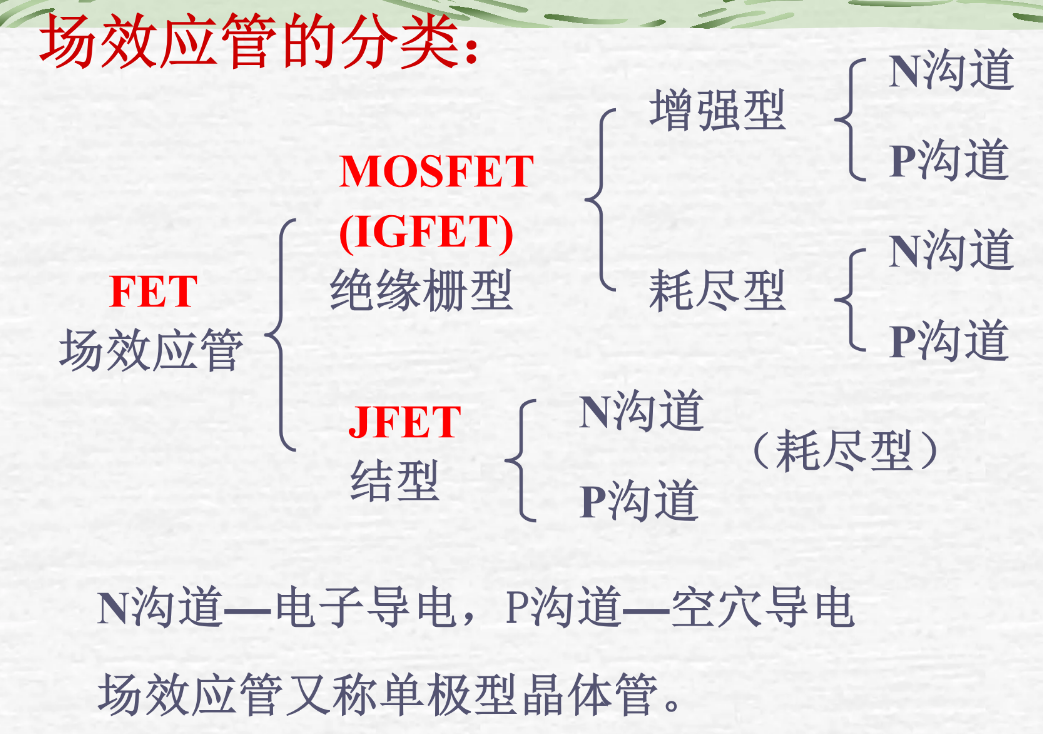
MOS是金属-氧化物-半导体单词的前面的首字母
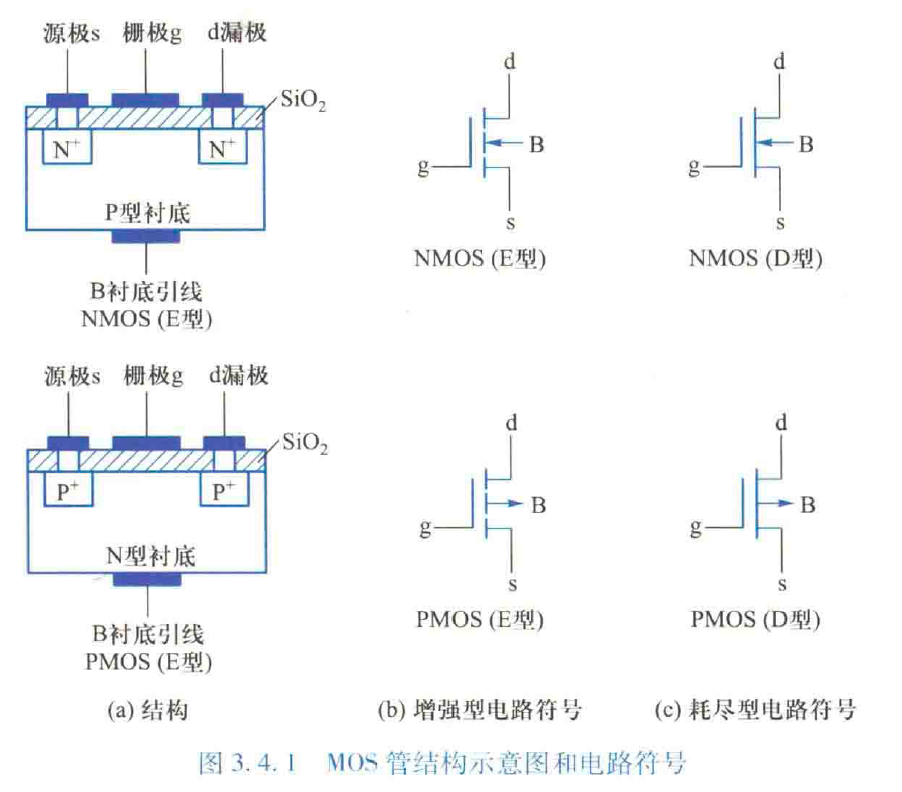
增强型的三根线是断开的,耗尽型的是连起来的。N型的B处箭头往里,P型的B处箭头往外,这个箭头是从P指向N的
绝缘栅型场效应管(MOS)¶
MOS管,以增强型NMOS为例
微观原理¶
第一步,从微观原理解释各个状态及其发生条件
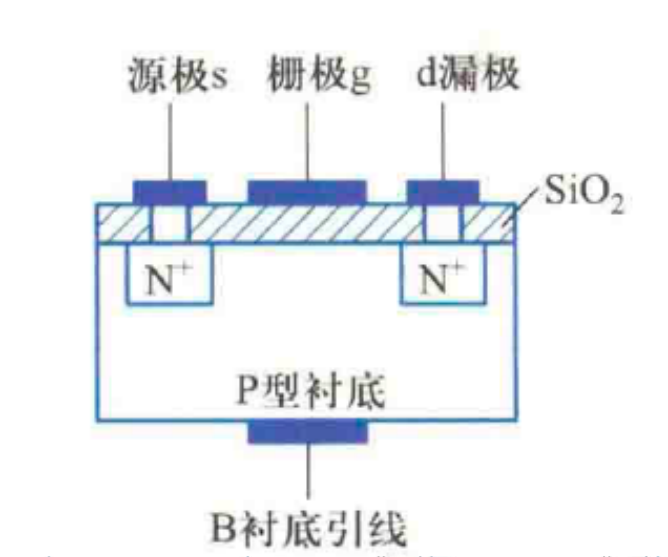
注意白色部分全部都是P型半导体,下面那个B只是金属
采用共源极接法,也就是在G和S之间接一个电压,在D和S之间接一个电压,同时S和B是用导线相连的
VGS较小时,不论VDS加多少电压,D和S中间就是两个背靠背的PN结,不会有电流。
VGS超过开启电压VT之后,由于VGS也相当于VGB(B和S相连),此时有从上到下的一个电场,吸引P型半导体的少子电子靠近栅极,多子空穴被排斥远离栅极,此时形成所谓的导电沟道,可以认为把两个N+给连了起来
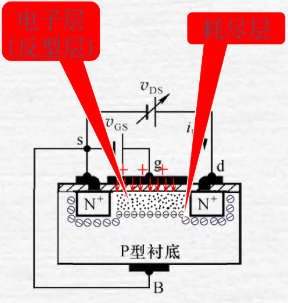
如果此时加了VDS,那么就有漏极电流了。VGS越大,电子层就越厚,导电性就越好,漏极电流就越大。另外VDS越大,加的电压就越大,电流也越大。在一开始VDS比较小的时候,确实是这样的规律,此时通了电流之后,电子层的分布会发生变化,我通过具体的电压值来解释这个变化的原因
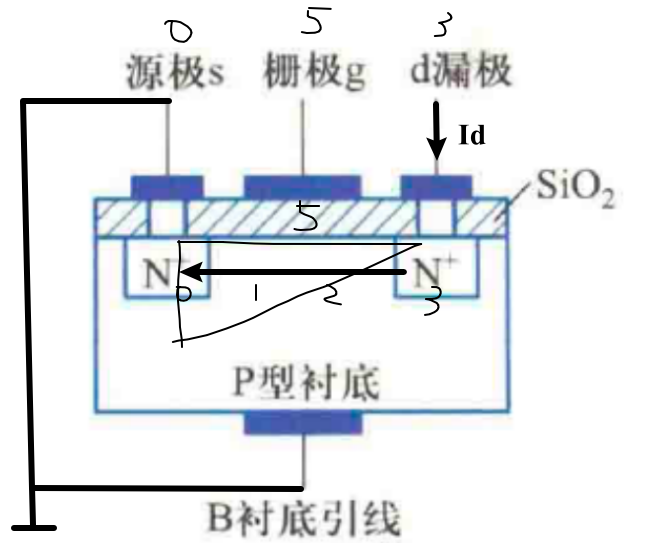
VGS=5V,VDS=3V,VT=2V。我这里假设电流上的压降是等间隔的下降的,那么在导电沟道里的电压就是从0到3的。决定导电沟道的大小的就是这条路上某一点的电势和栅极的电势之差。比如S那里,VGS=5V>2V,于是那里形成了导电沟道。然后1V那里,5-1=4V>2V,于是那里也形成了导电沟道,但是由于这个电压比5V小,所以形成的导电沟道没那么宽。然后2V那里,5-2=3V>2V,也形成导电沟道,但就更细了。最后VGD=5-3=2V=VT,那就只能恰好形成导电沟道,这个时候它就是最细的了,因此导电沟道呈现的是这样的楔形分布。
我这里给的数值是比较“刚好”的,也就是漏极恰好能形成导电沟道。如果VDS少一些,那就不会这么极限,即使是漏极那边,也还是有一定的宽度的。在VGS>VT, VGD>VT时,此时称为“可变电阻区”,所谓的可变电阻,就是导电沟道的等效电阻由VGS在控制。VGS增大,导电沟道变宽,等效电阻变小。这个时候VDS仍然能够保证漏极有一定宽度的导电沟道,满足VGS-VDS=VGD>VT
当VGD=VT的时候,也就是我上面给了具体数值的这种情况时,漏极刚好能形成导电沟道,此时称为“预夹断”。实验发现,在VGD<VT, 也就是VDS进一步增大之后,漏极电流几乎不变,称为“恒流区”。如果按照我上面的解释来说,漏极已经无法形成导电沟道,电流应该为0,但是实验得到的结果并不是这样的,所以需要另外的解释。
我整合老师的解释和AI问来的解释拼凑出了一种解释。当VDS进一步增大导致VGD
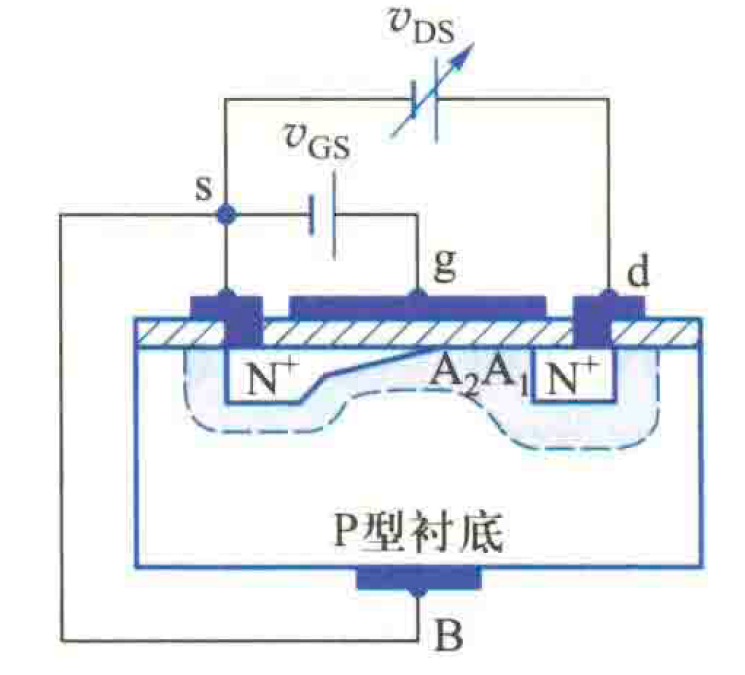
这耗尽层很特别,它也可以被称为“预夹断区”,它会把A2来的电子直接快速传到d,而且不对电流做贡献。VA2S(也就是预夹断点到源极的电压)是VGS-VT,我之前举的例子也是这样的。当VDS继续改变的时候,VA2S不再改变,而VDA2就承担了增加的VDS的这部分电压,然后不会影响电流。此时电流完全由导电沟道部分来决定。当VDS改变时,导电沟道部分的等效电阻几乎不变,然后VA2S也比较稳定,所以就导致电流几乎不变了。为什么导电沟道等效电阻几乎不变,因为VDS继续增大时,虽然A2会继续左移,但是幅度很小,所以就认为不变了。
总结,VGS>VT,VDS>0是有电流的前提,而在这基础上,如果VGD<VT,就会进入奇妙的恒流区,至于解释的话就仁者见仁智者见智了,反正就是这么个现象。
输出特性和转移特性曲线¶
第二步,解释曲线各个部分所在的区
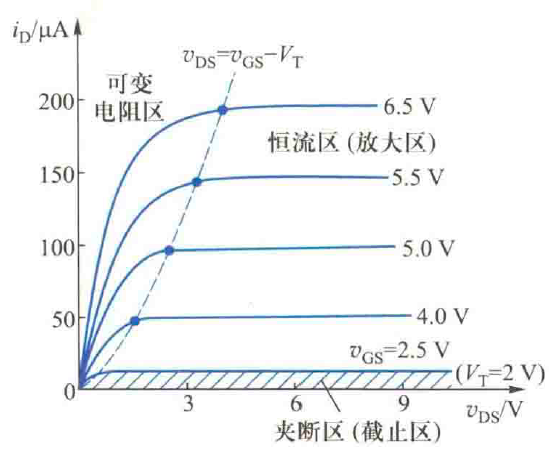
这是共源极输出特性曲线,就是漏极特性曲线。当VGS≤VT=2V,没有导电沟道,可以认为没有电流,称为截止区
VGS>2V(有导电沟道),VGD>2V(漏极有导电沟道)时,称为可变电阻区。随着VDS增大,加的电压增大,电流增大很自然。同一个VDS,VGS增大,导电沟道变宽,等效电阻减小,于是电流增大也很自然。
VGD=2V时,是预夹断,也就是那条斜线
VGS>2V, VGD<2V时,进入恒流区,VDS增大不会影响电流。同一个VDS,VGS增大,导电沟道部分等效电阻减小,所以电流增大,很好解释。

这是转移特性曲线,就是研究VDS不变时VGS的变化对于电流的影响。VGS只有大于VT时才有电流,所以刚有电流的地方就是VT了。VGD=VGS-VDS,图中画出来的地方,显然VGS-VDS=VGD都小于2V,所以都是在恒流区。VDS一定,VGS增大,则导电沟道等效电阻减小,所以电流增大。
这条曲线在不同的VDS情况下(保证在恒流区),几乎重合,就当作一条曲线了。
电路模型¶
第三步,介绍电路中三极管状态的判断和相应模型
假设G和S点断开,结合外部电路求出来VGS<VT,说明FET管位于截止区,ID=0,DS断开
假设G和S点断开,结合外部电路求出来VGS>VT,假设在恒流区,满足
\(I_{DO}\)是VGS=2VT时的漏极电流(恒流区),一般题目会给,如果不给的话就是让你从图里读,判断出VT,然后找出VGS=2VT那条线横流部分的对应电流的值,大概估一下就行。
有了这个方程配合外电路直接解出ID,然后求出VGD(一般是先求VDS然后和VGS减一下),看看是否符合VGD≤VT,如果是的话就没问题,确实在恒流区。如果不是的话那就是在可变电阻区。可变电阻区就没有公式了,得要用图解法。
推广¶
上面介绍了增强型NMOS管,很容易推广到增强型PMOS管,电流参考方向反过来,电压坐标轴变成负的,而且VGS也都成了负值
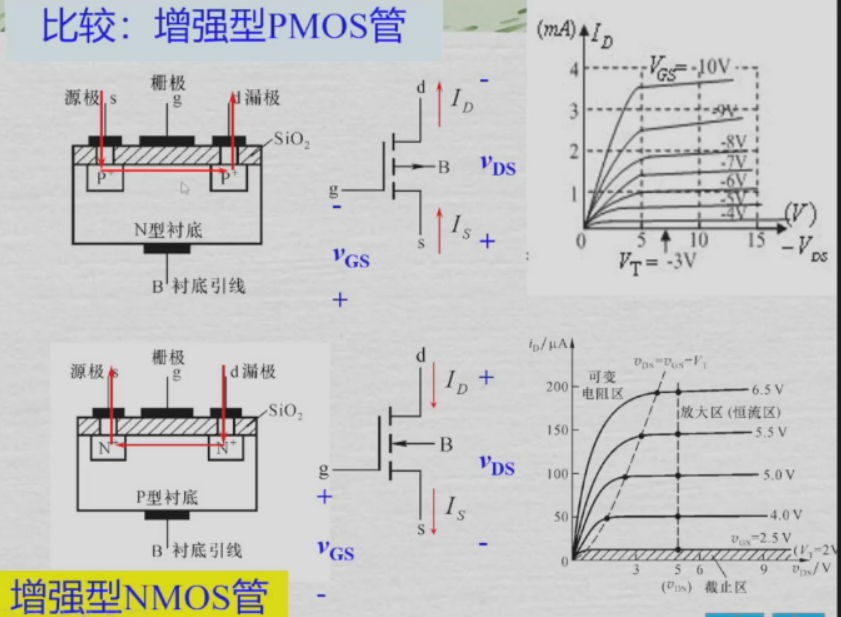
对于增强型的P,开启电压VT直接填带负值的,比如上面这个图里就是-3V
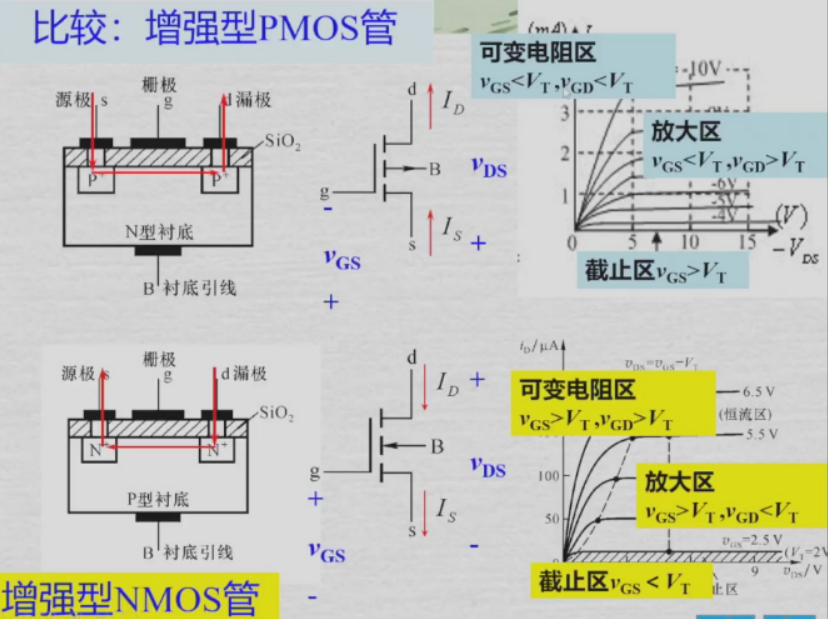
注意不等号都反过来了
增强型的介绍完了,可以推广到耗尽型的。耗尽型的NMOS给二氧化硅掺了正离子,所以VGS=0时也可以形成导电沟道。为了让它截止,需要VGS<0才能使得导电沟道没有,恰好没有的时候的VGS记为夹断电压VP
耗尽型可以理解为把VGS的坐标移动了
这里还是专门介绍一下耗尽型NMOS的曲线。

夹断电压就是最低的那根线对应的,而转移特性电流方程就相当于把增强型NMOS的往左平移了。此时这个饱和漏极电流注意是VGS=0时的恒流区电流,其实实际做题更简单了,不用找VGS=2VT的曲线了,直接找VGS=0时的去读就可以了,这个方程也是要记下来。电路的时候根据VGS和VP的关系判断是否截止,如果不是截止就先假设在恒流区用这个方程求出来电流,结合外电路求出VGD,根据VGD是否大于VP来判断假设是否成立,一样的思路,只不过对比的数值需要改一下了。
从耗尽型NMOS推广到耗尽型PMOS也是类似的,把电流参考方向反过来,电压轴变成负值,然后VP变成正的
参数¶
例题¶
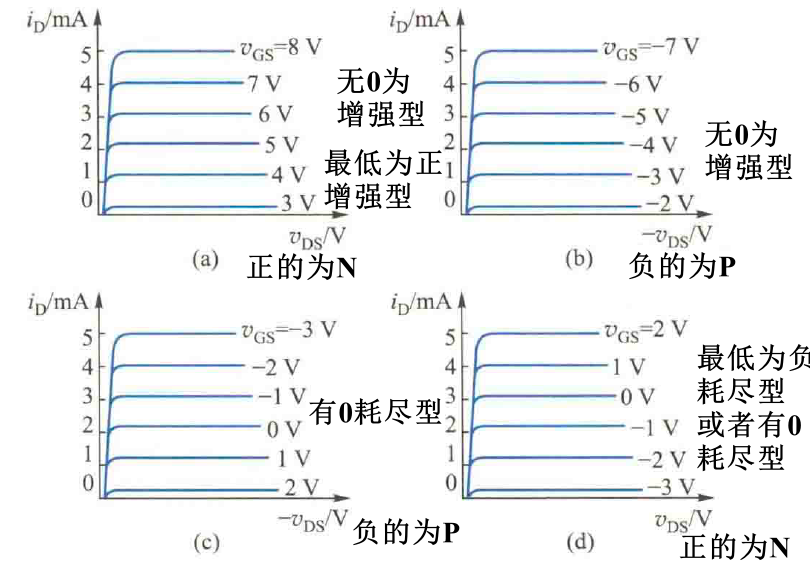
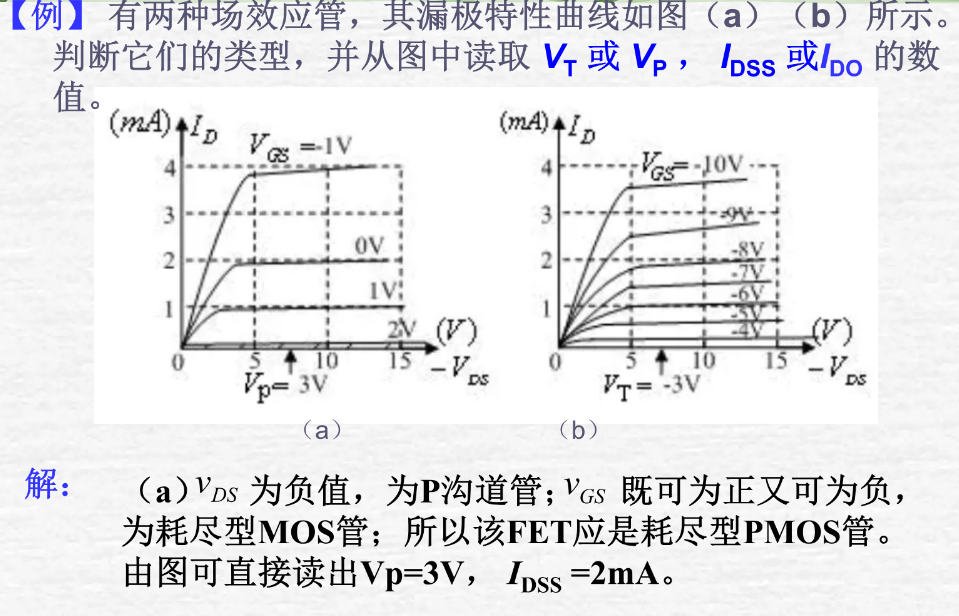

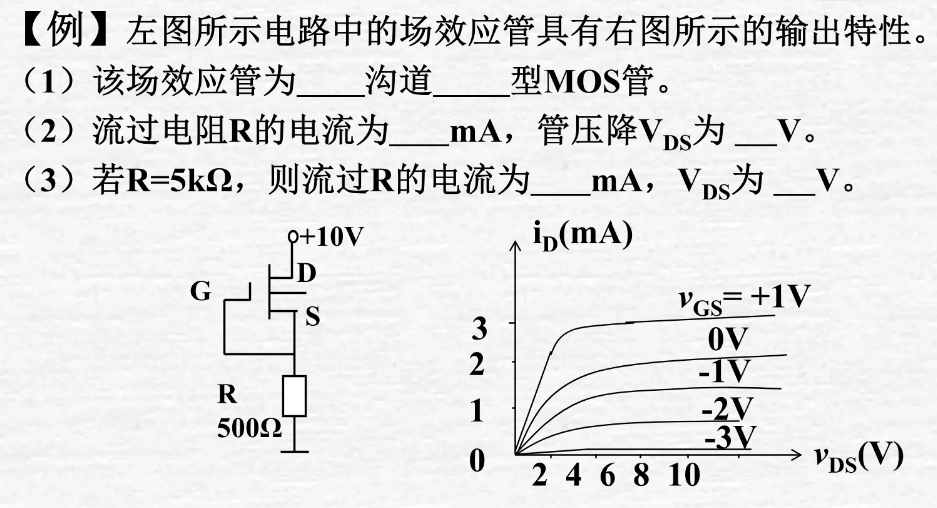
VDS是正的,所以是N沟道(P会改变电压电流),由于VGS可正可负,所以是耗尽型
这里GS短接,VGS=0,显然不可能截止,只能恒流区或者可变电阻区
先假设在恒流区,iD=2mA,由于iG=0,所以列10V的KVL,解出VDS=9V,接下来校验VGD=VGS-VDS=-9 < Voff,Voff和VP是同一个意思
然后如果改成R=5000,假设在恒流区,iD=2mA, 求出VDS=0,VGD=0>Voff,那这里就不符合假设了,所以在可变电阻区。
为了求出电流,把外电路用戴维宁等效,DS以外是10V的开路电压,2mA短路电流,然后呢画一条负载线,交点就是对应的数值,具体数值不用太精准,这里读1.5mA和2.5V就行
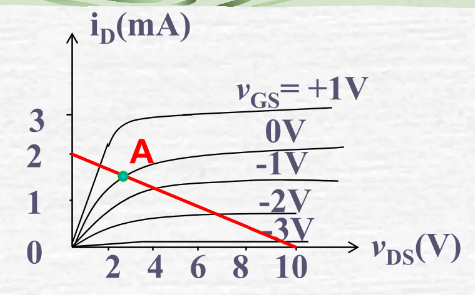
结型场效应管(JFET)¶
JFET的原理是要比MOS管简单的,就大概介绍一下
微观原理¶

以N型JFET为例
JFET不加电压的时候就有导电沟道(两个耗尽层(PN结)中间的白色部分),所以它是耗尽型。
先看N沟道JFET,我们只讨论VGS<0的情况,当VGS<0,两个PN结反偏,耗尽层扩大,挤占中间的位置,使得中间那条导电沟道变窄。当VGS达到夹断电压Voff,无论加多少VDS,电流都为0。
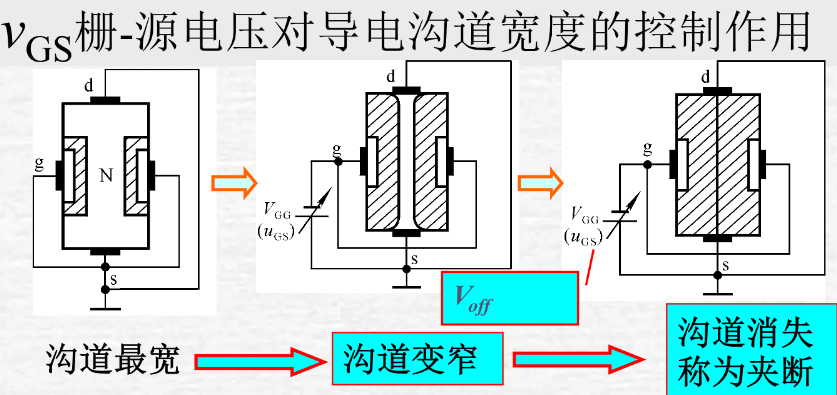
导电沟道的宽度由G和中间某点的电压决定,当加了VDS>0(我们只讨论VDS>0),电压从D到S下降,我这里也给一个具体的数值

注意,反压越大,PN结越厚,阻断的程度越高。VGS=-3,有一定程度的反压,耗尽层有一定厚度。1V处,-3-1=-4,比-3要大,此处耗尽层更厚,往上到4的地方,-3-4=-7,更厚。最后到5,-3-5=-8,耗尽层最厚,电阻最大的地方。当Voff<-8时,这个电流才能导通,如果Voff=-8,那这个时候就叫预夹断,如果Voff>-8,那么就出现了类似MOS管那样神奇的现象,恒流了。解释的话我也用类似MOS管的解释,就是还有导电沟道的地方,压降稳定为VGS-Voff,然后它等效电阻几乎不变所以恒流,然后呢VDS继续增大的压降就加在了耗尽层那一段。
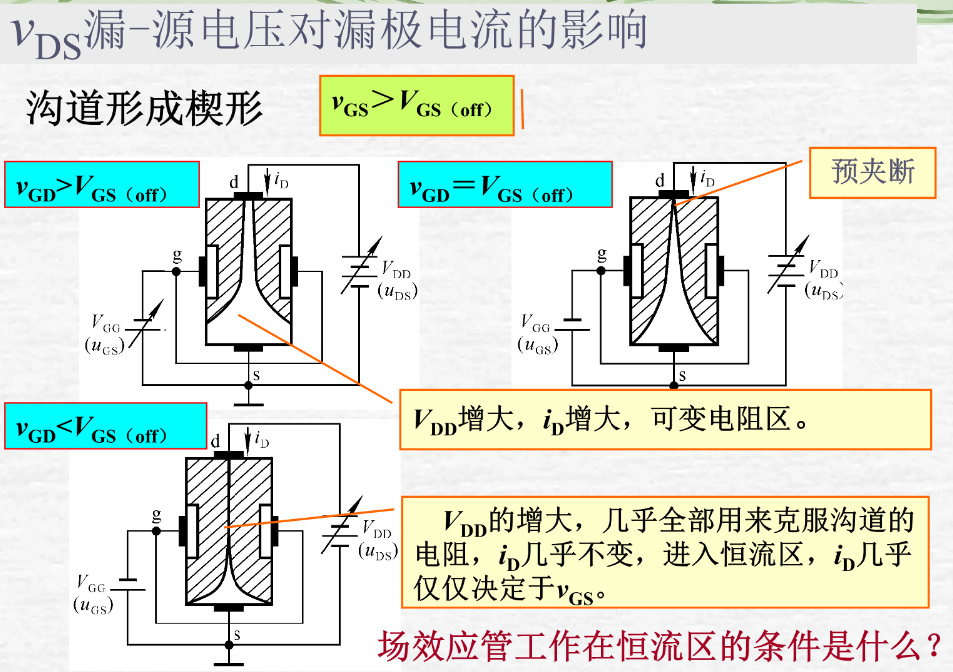
总结,VGS>Voff是有电流的前提,在此基础上VGD<Voff是进入恒流的条件。
输出特性和转移特性曲线¶
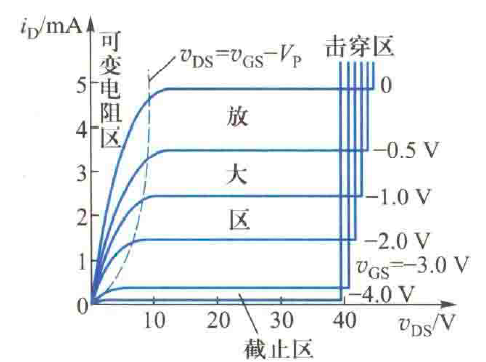
这是N型JFET管的输出特性曲线。当VGS
VGD=Voff时,预夹断
VGS>Voff,VGD<Voff时,进入恒流区,同一个VDS,VGS绝对值增大,则反压增强,导电沟道更窄,电阻增大,电流减小。

这是N型JFET的转移特性曲线
由于只讨论VGS<0,所以只画一部分。VGS>Voff才有电流。图中VDS=15V,VGS从-4到0,VGD最大也不超过-15V,一定是小于Voff,所以就会在饱和区,图中的都是在饱和区。当VGS绝对值减小,导电沟道变宽,电阻减小,所以电流增大。
这个也是在VDS不同的时候都当作同一条曲线了。
电路模型¶
假设G和S点断开,结合外部电路求出VGS<Voff,说明JFET在截止区,ID=0,DS断开
假设G和S点断开,结合外部电路求出VGS>Voff,假设在恒流区,满足
I_DSS时VGS=0时的电流
根据这个方程配合外电路解出ID,求解VGD,如果VGD
推广¶
介绍了N型JFET那就再扩展到P型JFET
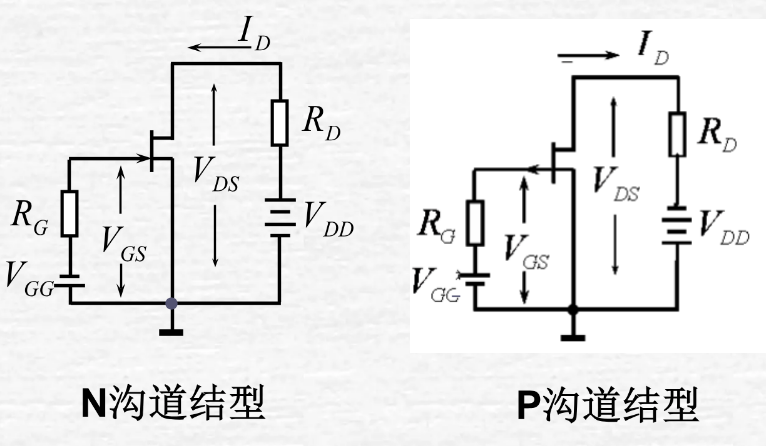

这里P沟道耗尽型的转移特性曲线没有把VGS加负号,这就导致图是关于y轴对称的
参数¶
例题¶

我说一下为什么ID=2mA不合题意,因为IDSS就是2mA,要满足这个的话,VGS=0,显然如果有ID的话是不可能做到的,所以这个就舍去
其他管¶

由于β很大,认为合并之后的β就是β1β2,忽略一次项
等效管的类型你就看几个进几个出就行,两进一出的是NPN,一进两出的就是PNP
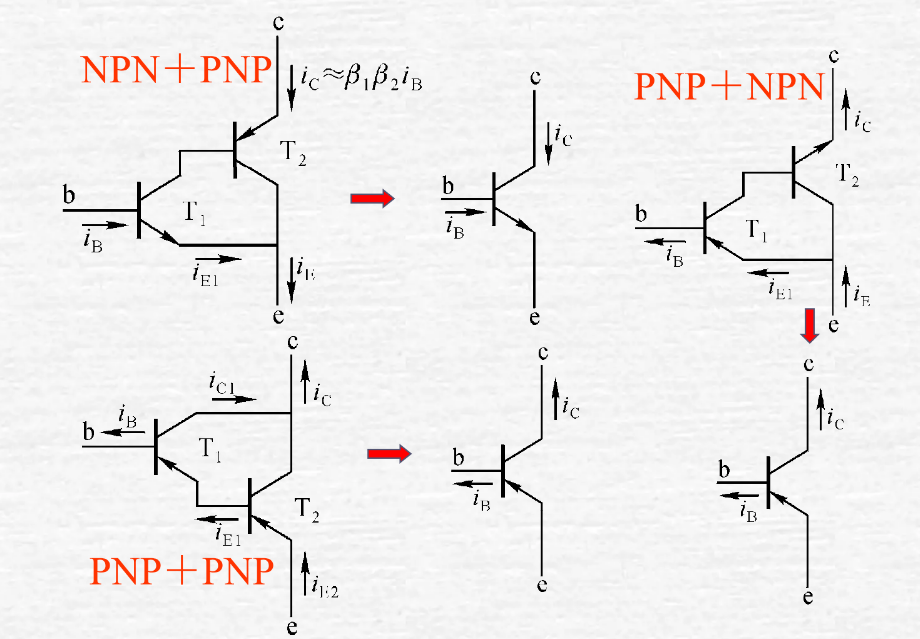
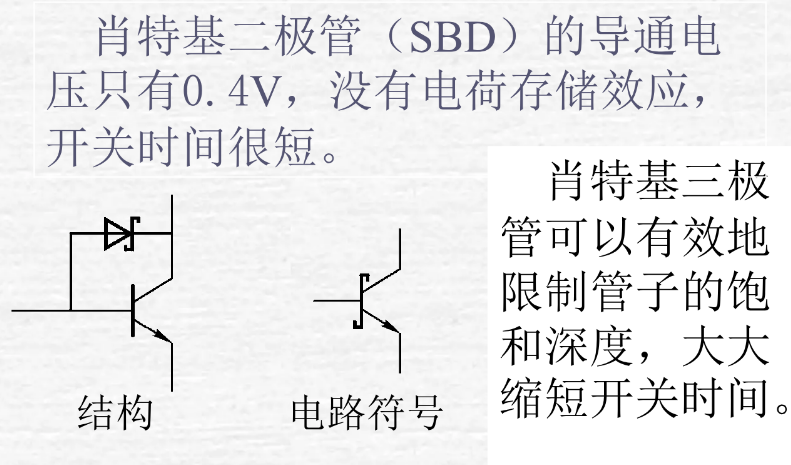

横向对比¶
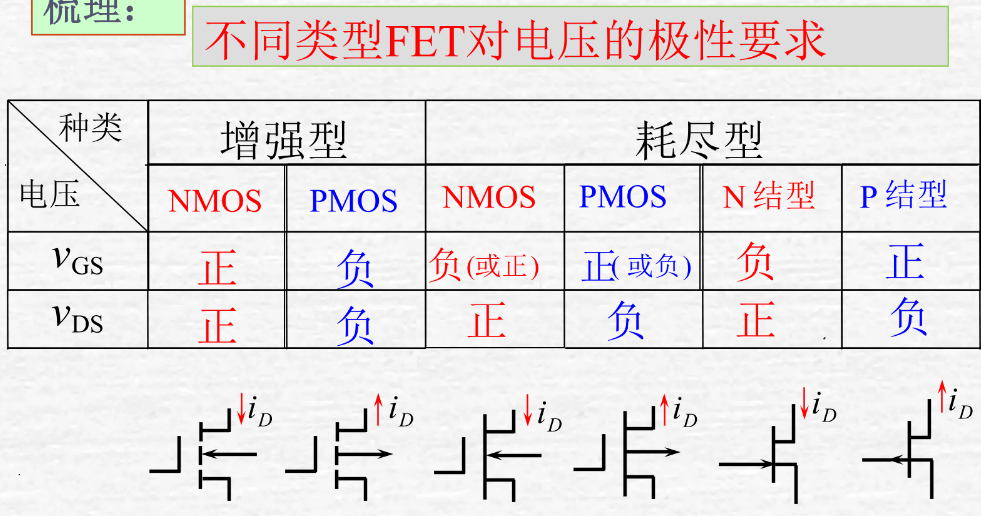
所有N沟道电流都是d往s,所有P沟道电流都是s往d。从负号判断N沟道还是P沟道就看那个箭头往哪里,这个箭头的方向朝里就是N,朝外就是P


